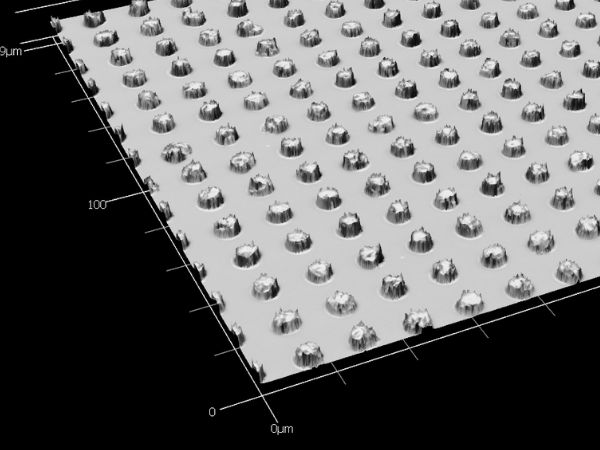
Bonding
铟凸点互连(IBI)倒装芯片键合
在越来越大的芯片上,更高的像素/量子位计数和互连密度的需求正在推动芯片技术的融合和单片集成。这导致对细间距微型铟凸点互连(IBI)倒装芯片键合解决方案的需求增加。
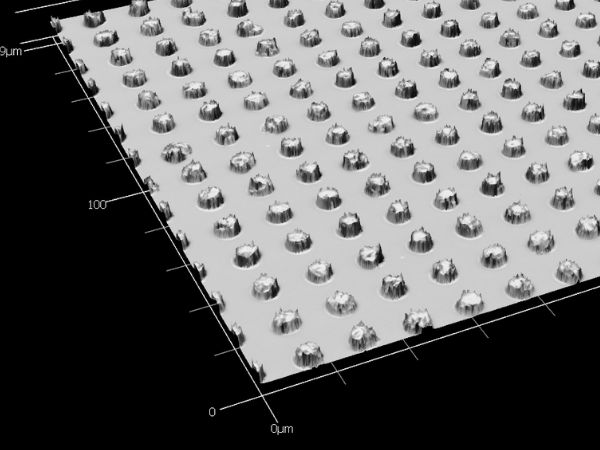
在越来越大的芯片上,更高的像素/量子位计数和互连密度的需求正在推动芯片技术的融合和单片集成。这导致对细间距微型铟凸点互连(IBI)倒装芯片键合解决方案的需求增加。
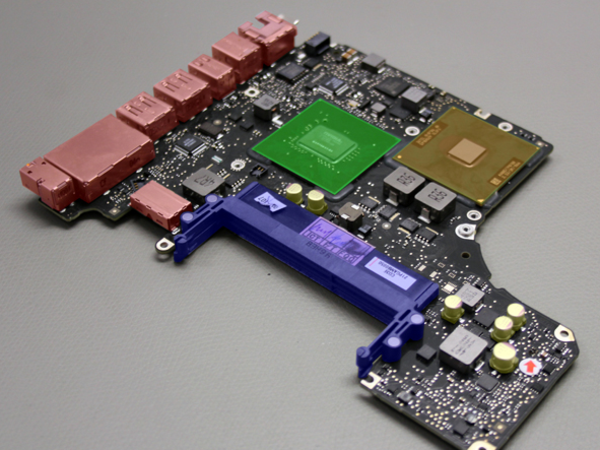
大型球阵列BGA、处理器单元(CPU)、图形处理芯片(GPU)和细间距阵列CSP对返修工作台的配置提出很高的要求:精确的热量管理、高精度贴片和高光学分辨率。

我们的技术文件以简洁易懂的方式提供了关于选定的应用和工艺的基础知识,并针对其具体要求提出了合适的产品解决方案。